In-line semiconductor N2 process critical dimension X-ray metrology tool (XRCD)


In the 2nm node semiconductor process, GAA three-dimensional structures face challenges such as new materials and require super high resolution monitoring to ensure process yields. The team develops this 2 nm node front-end metrology tool based on X-ray technology. The XRCD metrology tool measures multilayer GAA structures and monitors critical dimensions with atomic-level resolution, reducing measurement time by 90%. The target market includes foundry and memory below N2 process node. The market is expected to be USD 130 million in 2025, with an annual growth rate of 36.8%.
測試
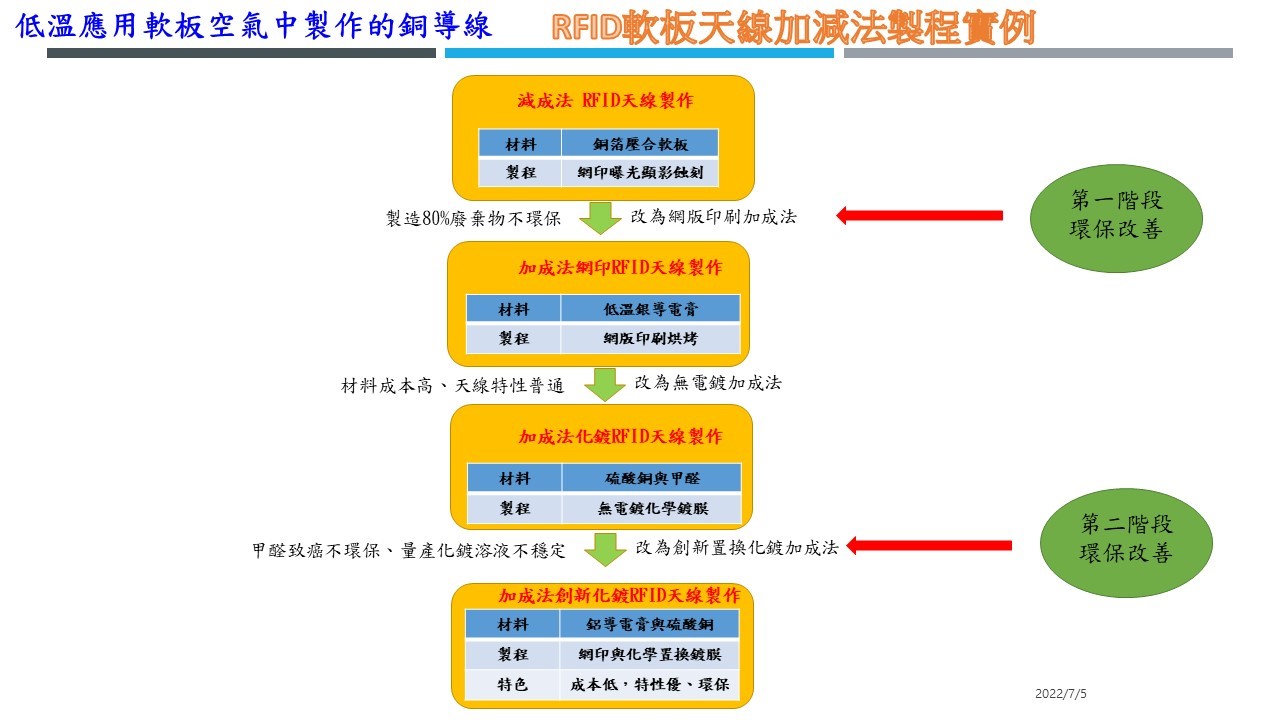
Utilization of novel chemical displacement environmental protection coating technology to be applied on RFID antenna production
Functional Dyeing Synchronized with CO2 Supercritical Technology
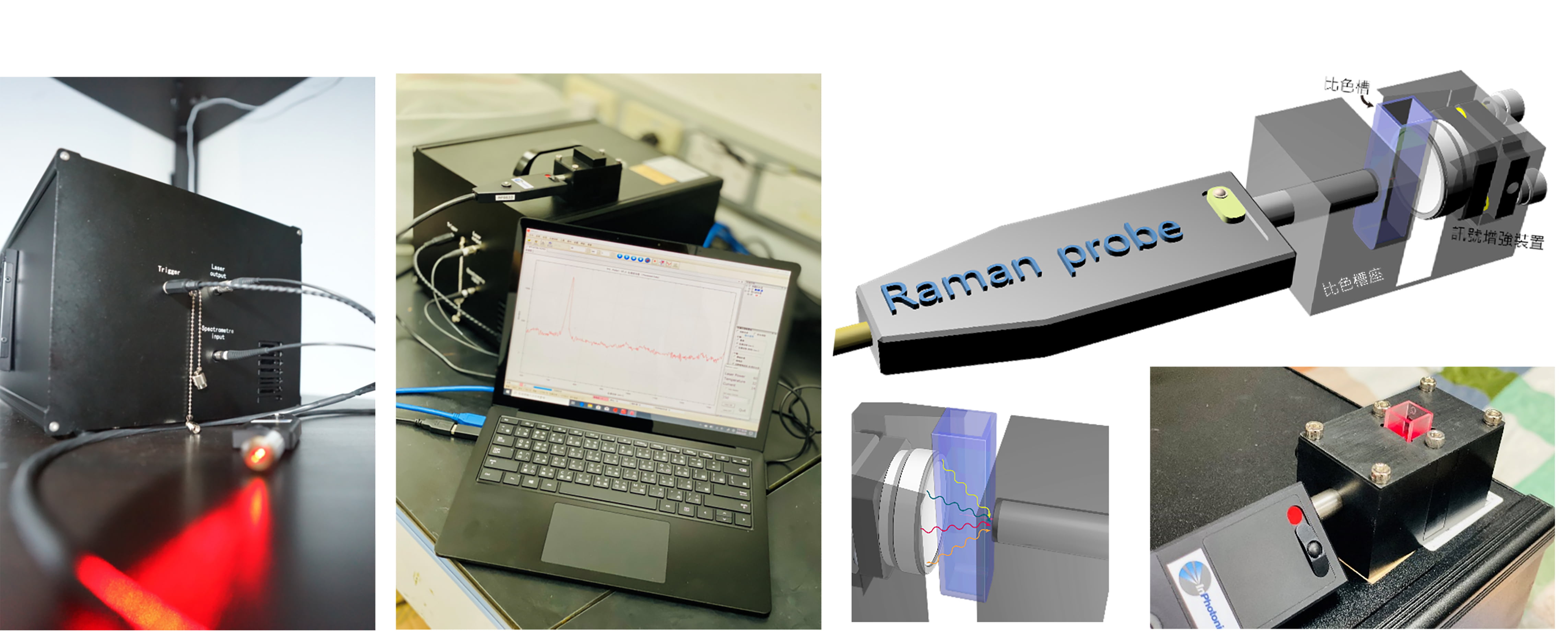
Magnetic and 2D metallic Nanoparticle Arrays of Surface-Enhanced Raman Spectroscopy (SERS) Detection Platform for Environmental-Biomedical Sensing

The Engine for Novel Chemical Engineering Process Development: a Fully Automated Platform for Comprehensive Physical Property Prediction
Technology maturity:Prototype
Exhibiting purpose:Product promotion
Trading preferences:Technical license/cooperation
*Organization
*Name
*Phone
*Main Purpose
*Discuss Further
*Job Category
*Overall Rating
*Favorite Area
*Key Tech Focus
*Willing to Receive Updates?
Other Suggestions
Coming soon!