Optimizing Advanced Process Control Decision and Virtual Metrology Technology for Nano Technology Nodes for Semiconductor Manufacturing


This technology is developed for optimizing advanced process control decision and virtual metrology for nano technology nodes for semiconductor manufacturing. The accuracy can reach up to 84.4%, while advanced process control can be improved by 5% under the scenario of metrology delay. When new process excursion occurred especially when ramping up new technologies and products, the monitoring rules can be redefined for intelligent fault detection and classification via CNN transfer learning to effectively shorten the self-learning cycle time. It can balance the productivity and product yield while effectively shortening yield ramping and mass production time.
National Tsing Hua University (NTHU), established in 1911 and located in Hsinchu, Taiwan, is one of the top research universities in the country. NTHU offers a wide range of programs in fields such as engineering, science, management, and humanities. The university is known for its strong emphasis on innovation, research excellence, and fostering global perspectives. With a commitment to academic rigor and interdisciplinary collaboration, NTHU plays a key role in advancing knowledge and technological development, contributing to both Taiwan’s growth and the global academic community.
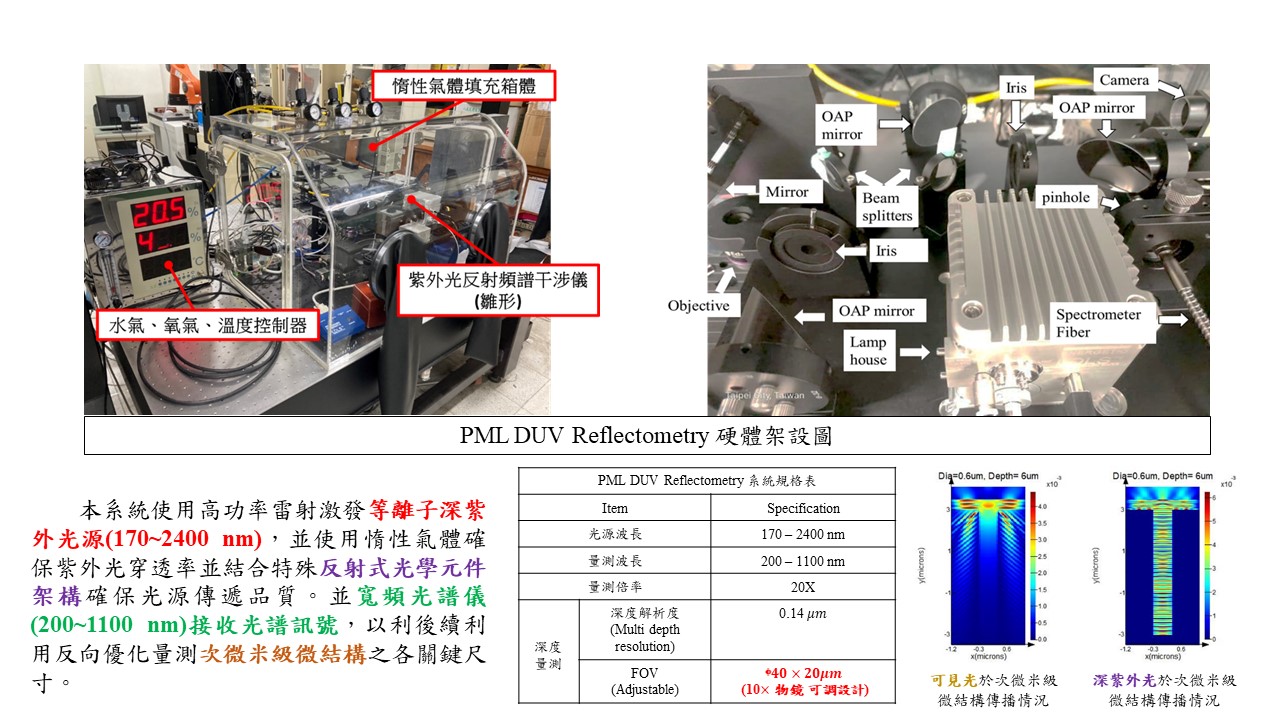
Optical critical-dimension measuring technology for high-aspect-ratio microstructures in advanced semiconductor packaging

World-class ultra-precision optical processing technology and the non-contact floating display application
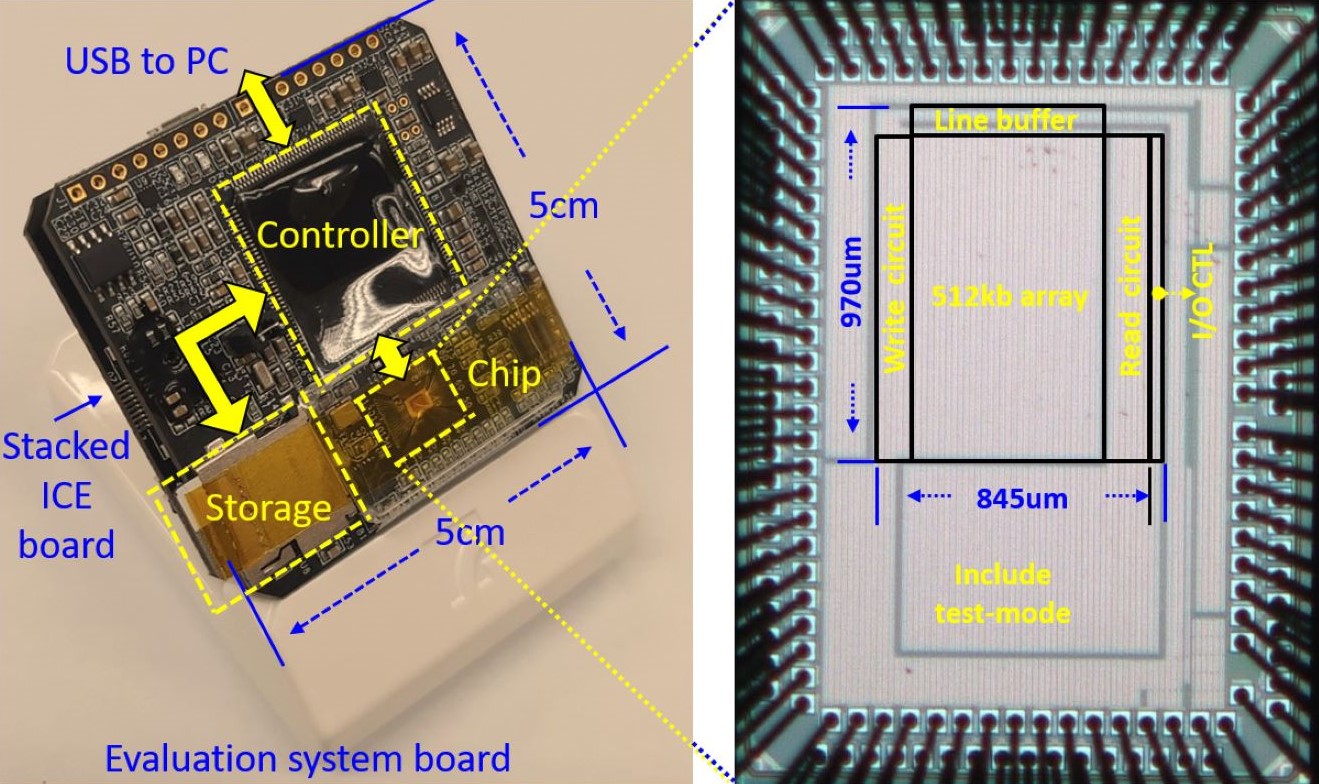
Energy-Efficient Optimization Problem Decision: Neural Network-based In-Memory Annealing Units for Route Scheduling and Genome Assembly

Monolithic 3D Heterogeneous Device Integration and Innovative Materials for Breaking Logic Density Limits: A Key Technology Platform for High-Density AI Computing Chips
Technology maturity:Prototype
Exhibiting purpose:Display of scientific results
Trading preferences:Technical license/cooperation、Negotiate by self
*Organization
*Name
*Phone
*Main Purpose
*Discuss Further
*Job Category
*Overall Rating
*Favorite Area
*Key Tech Focus
*Willing to Receive Updates?
Other Suggestions
Coming soon!