
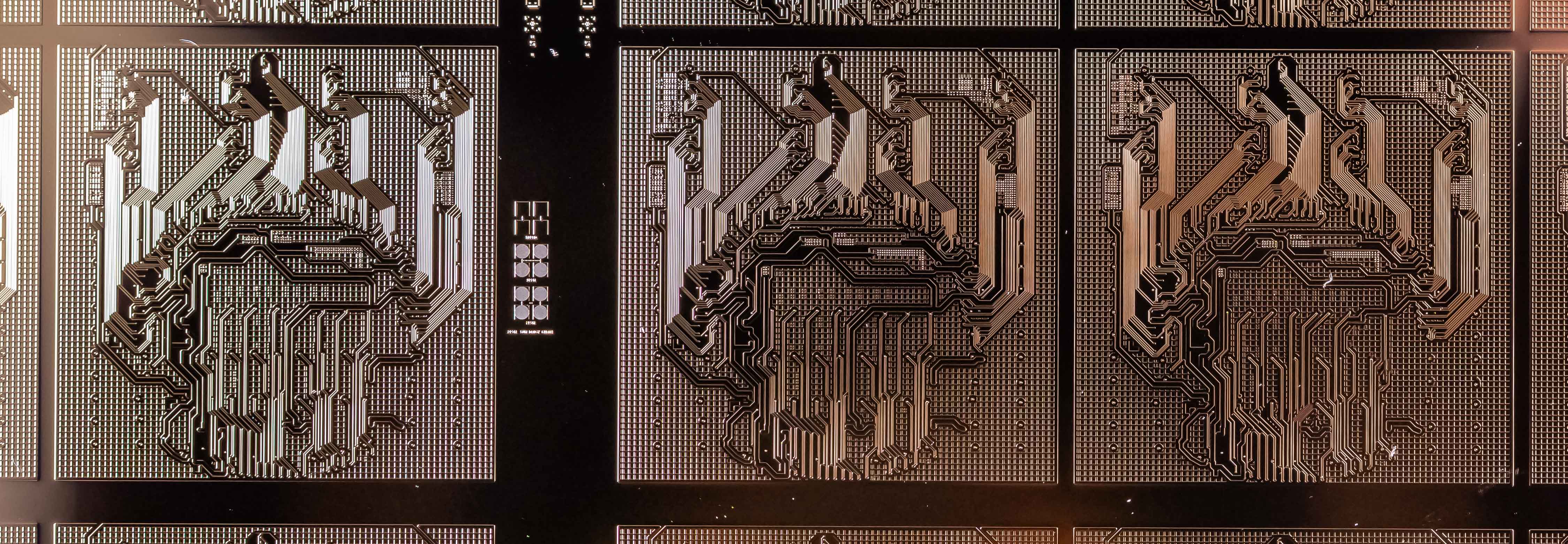


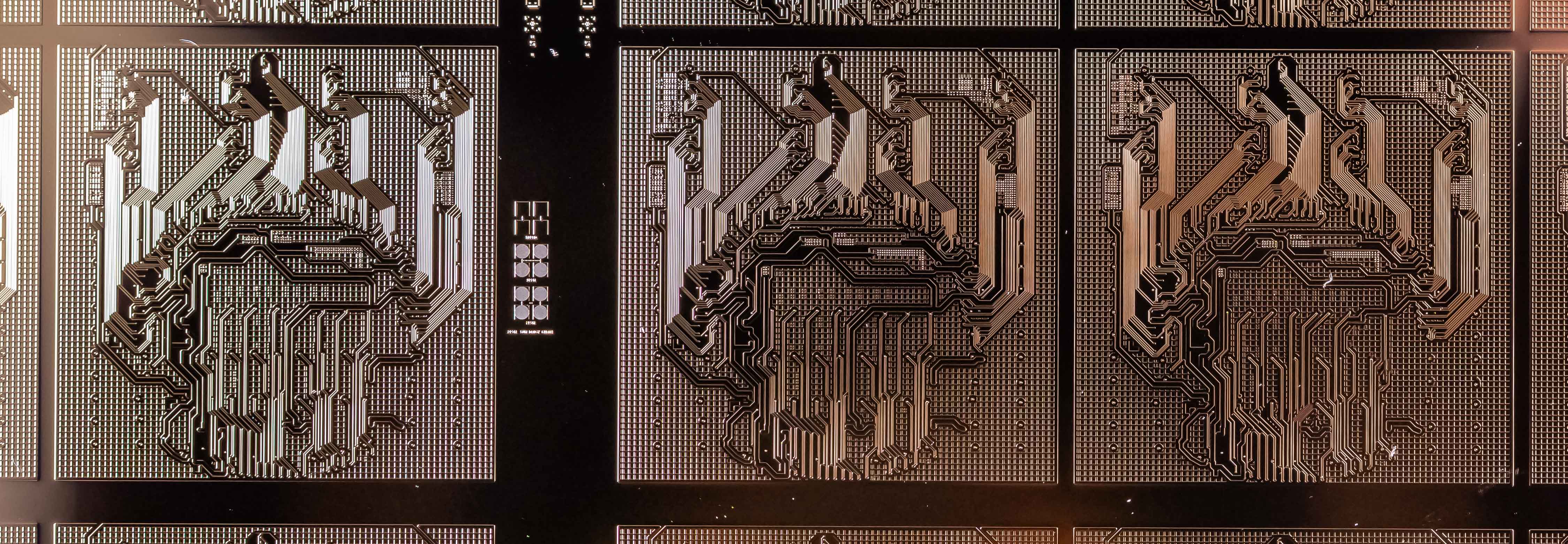
隨著高頻、高密度異質整合需求增加,先進封裝如2.5D/3DIC、小晶片及扇出型封裝需要高精度、低翹曲的多層再配線層(RDL)。傳統RDL製程因多層堆疊易產生熱應力,導致晶圓翹曲問題,影響後續製程良率。低翹曲Cu/Polymer Multi-layer接合技術可有效降低應力,提升封裝精度與可靠性。採用低CTE差異材料設計,選用奈米細精銅與PI、PBO等高分子材料,並透過應力補償設計減少翹曲,製程溫度低於200°C、持續1小時即可完成接合。此技術異質整合晶片,提升AI、5G與自駕車晶片應用。
工業技術研究院是國際級的應用研究機構,擁有六千位研發尖兵,以科技研發,帶動產業發展,創造經濟價值,增進社會福祉為任務。自1973年成立以來,率先投入積體電路的研發,並孕育新興科技產業;累積近三萬件專利,並新創及育成,包括台積電、聯電、台灣光罩、晶元光電、盟立自動化、台生材等上市櫃公司,帶動一波波產業發展。
技術成熟度:量產上市
展示目的:可交易技術
流通方式:專利授權/讓與
*服務單位
*姓名
*電話
*您參觀這項展品的主要目的?
*您是否希望進一步洽談
*您的職務類別
*展覽整體評價
*最喜歡的展區
*期待展覽著重的技術領域
*是否願意收到電子報/最新資訊
其他建議
敬請期待!