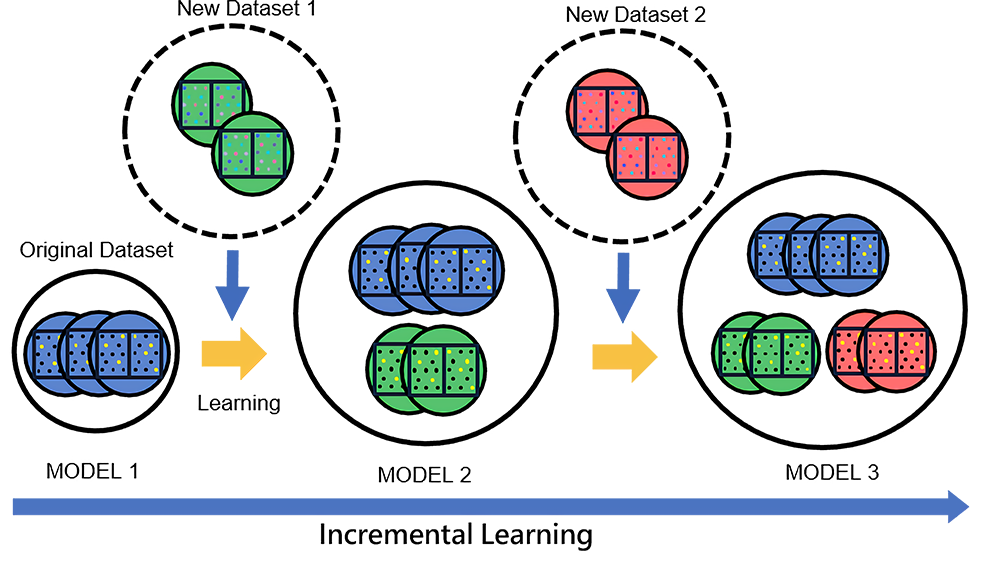
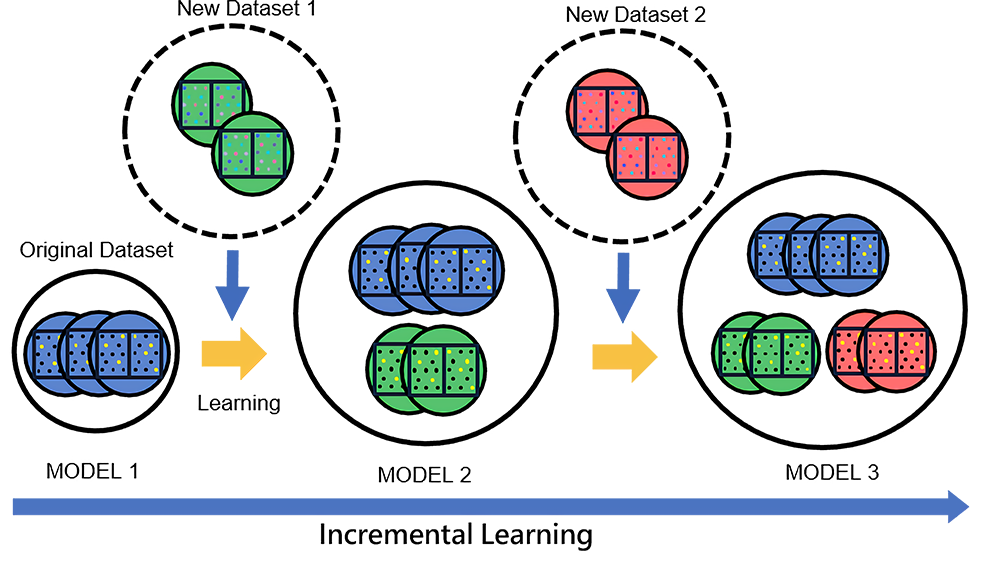
●技術說明:
透過「微影覆蓋誤差量測的抽樣與預測」技術,降低誤差量測的成本與時間,以提高製程效率。經由分群技術與機增量學習模型演算法找出關鍵量測點,建立黃光覆蓋誤差量測點的減點演算法,並可因應產品客製化要求、晶圓種類繁複與樣本資料量測量少的問題,動態增量學習不同資料特徵,以達優化減點與降低成本之目標。
●技術之科學突破性:
由於實務上缺乏大量完整的各產品晶圓量測資料,我們利用分群技術結合增量學習符合客製化需求。開發動態分群演算法,使其針對不同型態屬性的資料自動給予適當分群數,並利用少量樣本資料逐步建立訓練模型,以擷取各分群中代表性的量測點,預測晶圓曝光補償。本技術在主要的績效標準方面都優於業界採用之商業軟體10%以上。
●技術之產業應用性:
目前因應合作廠商需求開發量測減點演算法,利用動態分群方法分析微影覆蓋誤差的共同特徵,並透過增量學習模型擷取代表性的量測點,以外推預測整片晶圓之實際曝光情況。我們也將該量測技術延伸至Wafer Probe測試階段,達成在測試製程階段降低量測成本之目標,並協助提升台灣半導體產業鏈之尖端技術與國際競爭力。
線上展網址:
https://tievirtual.twtm.com.tw/iframe/38af7052-8e98-4173-b72f-9af93918cc82?group=23bfb1fa-dd5b-4836-81a1-4a1809b1bae5&lang=tw
國立清華大學(National Tsing Hua University, NTHU)成立於1911年,位於新竹市,是台灣頂尖的研究型大學之一。學校提供多元的學科領域,包括工程、科學、管理、人文等,致力於創新研究與國際化發展。
技術成熟度:雛型
展示目的:商機推廣、研發成果展示
流通方式:專利授權/讓與、自行洽談
*服務單位
*姓名
*電話
*您參觀這項展品的主要目的?
*您是否希望進一步洽談
*您的職務類別
*展覽整體評價
*最喜歡的展區
*期待展覽著重的技術領域
*是否願意收到電子報/最新資訊
其他建議
敬請期待!