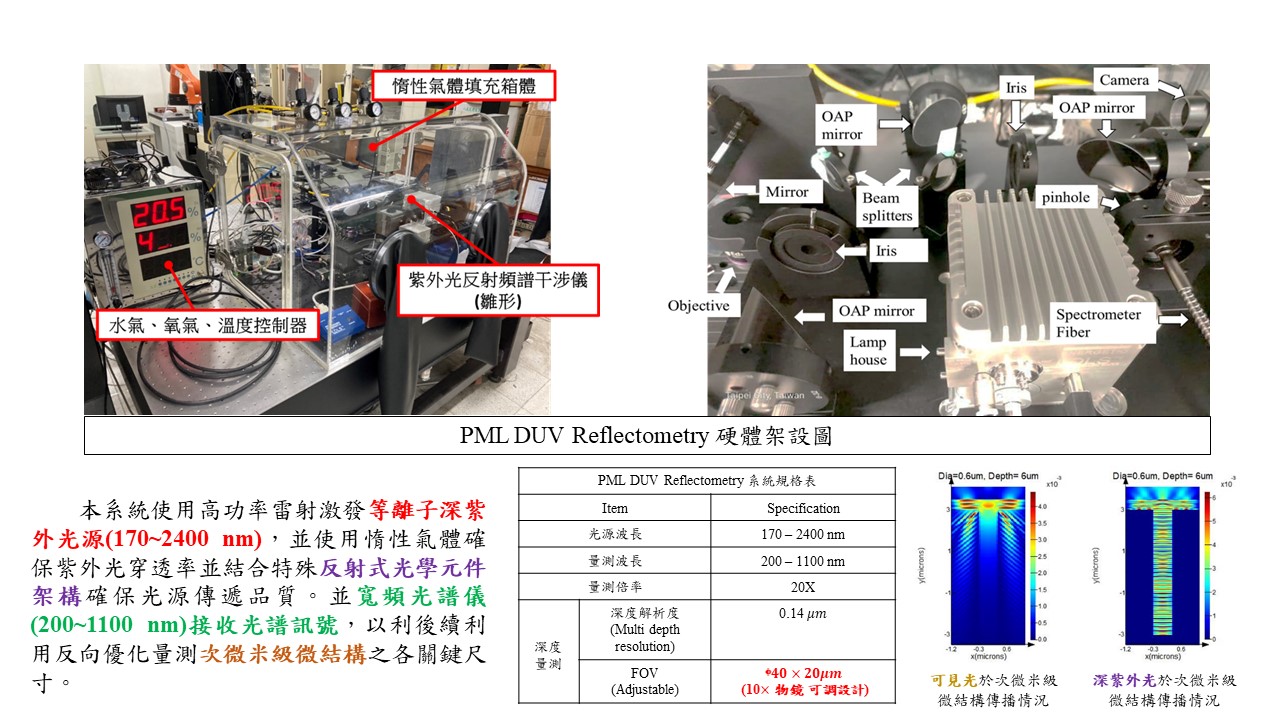
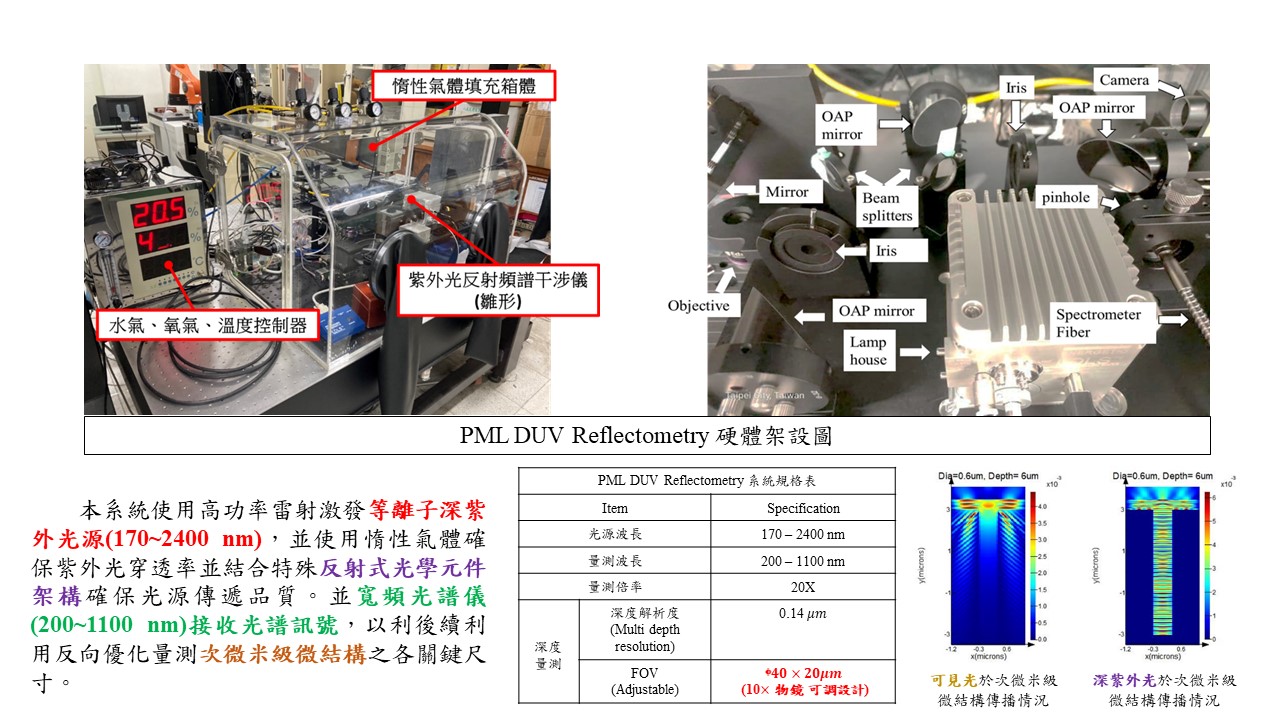
●技術簡介:
本團隊以創新光學量測原理為基礎,運用深紫外寬頻光源作為光學偵測方式,藉機器學習演算方式進行反向優化之最佳化工程,針對多項關鍵尺寸量測進行技術瓶頸的突破,已成功發展一套創新性光學關鍵尺寸光學量測系統軟體技術,其開口尺寸可達到次微米、深寬比達15倍之境界,達到世界半導體先進封裝界所領先之技術指標。
●技術之科學突破性:
本技術運用深紫外光源作為創新光學偵測方式,以機器學習演算進行模型反向最佳化,針對最小可量測孔徑與最大可量測深寬比進行關鍵量測瓶頸上之突破,最小孔徑可達0.3微米、最大深寬比達15倍之境界,同時可達成單一結構CD量測之能力,此為目前半導體先進封裝界領先之技術規格指標。
●技術之產業應用性:
本技術目前已獲國內First tier user的半導體業者證實其需求性,同時在設備合作開發方面已獲得致茂電子、與均豪精密、備商揚明光學的多年期產學合作以及先期技術轉移,所開發深紫外量測模組將與超精密晶圓量測平台進行整合與測試,以進行 Alva Test 驗證測試。
技術成熟度:雛型
展示目的:研發成果展示
流通方式:專利授權/讓與、技術授權/合作、自行洽談
*服務單位
*姓名
*電話
*您參觀這項展品的主要目的?
*您是否希望進一步洽談
*您的職務類別
*展覽整體評價
*最喜歡的展區
*期待展覽著重的技術領域
*是否願意收到電子報/最新資訊
其他建議
敬請期待!